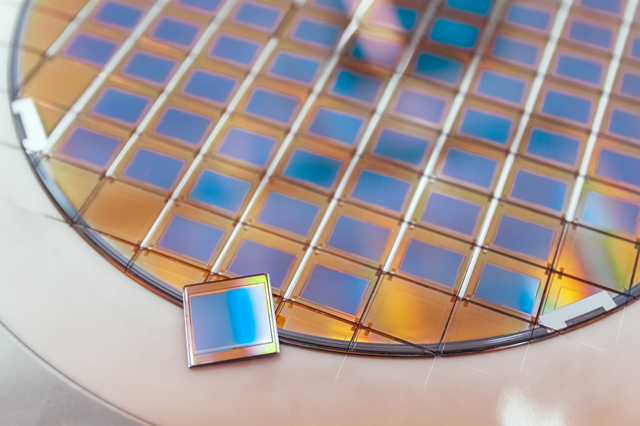
半導体製造の後工程において、製品の品質や信頼性を左右する重要なプロセスである「ダイボンディング」。
ウエハーから切り出された微細な半導体チップを、基板やリードフレームに高精度で固定するこの工程は、放熱性や電気特性、さらには製品寿命にも大きく関わります。
本記事では、ダイボンディングの役割や目的をはじめ、工程の具体的な流れ、使用される装置や接着方法までをわかりやすく解説します。
ワイヤーボンディングとの違いにも触れながら、後工程全体の理解が深まる内容になっています。
半導体技術に関心をお持ちの皆様に、基礎から学べる情報をお届けしたいという思いから、本連載を開始いたしました。
「これから半導体について学びたい」「技術の背景を理解したい」とお考えの方に向けて、できる限り平易で役立つ内容を発信してまいります。
当社「菅製作所」は、研究開発用途の真空装置を製造・販売しております。
現場で培ってきた知見をもとに、皆様の学びに少しでも貢献できれば幸いです。
本連載が、半導体に関する疑問の解消や、さらなる理解への一助となることを願っております。
ぜひ最後までご覧ください。
長年の経験と独自の技術で、大学や研究機関での導入実績も多数。
研究目的に応じたカスタマイズや、導入前のテスト成膜も可能です。
装置のご検討やその他ご相談は、ぜひ当社までお問い合わせください。
お問合せはこちら目次
半導体製造【後工程】におけるダイボンディングとは?
半導体製造は大きく「前工程」と「後工程」に分かれますが、ダイボンディングはその「後工程」の序盤に位置する極めて重要なプロセスです。
具体的には、ウエハーダイシング(ウエハーを切り分ける工程)によって個片化された半導体チップを、パッケージやリードフレームといった「土台」に固定する作業を指します。
もしこの固定が不十分だと、後の工程で不具合が生じたり、製品寿命が短くなったりするため、非常に高い精度が求められます。
まずは、なぜこの工程が必要なのか、どのような装置を使うのかを見ていきましょう。
ダイボンディングの目的
ダイボンディングを行う主な目的は、単にチップを貼り付けるだけではありません。
大きく分けて以下の3つの重要な役割があります。
- 半導体チップの固定
- 放熱性の向上
- 電気的な接続(電位取得)
1.半導体チップの固定
チップが動かないように物理的に安定させ、外部からの衝撃や振動から守ります。
2.放熱性の向上
稼働中の半導体は熱を発します。その熱を基板側へ効率よく逃がし、誤動作や故障を防ぐ役割を果たします。
3.電気的な接続(電位取得)
チップの裏面から電気的な導通(電位)を取る必要があるデバイスにおいて、その経路を確保します。
このように、製品の信頼性や性能を維持するために欠かせない工程なのです。
ダイボンディング工程に用いられる装置「ダイボンダー(マウンター)」
この精密な作業を自動で行う装置のことを「ダイボンダー」または「マウンター」と呼びます。
ダイボンダーは、あらかじめプログラムされた設計図に基づき、チップを正確な位置に高速で配置する役割を担います。
現代の半導体製造では、髪の毛の数千分の1というような微細な世界での加工が求められるため、人間の手ではなく、こうした高精度なロボットが必要不可欠です。
ダイボンディング工程の流れ
ダイボンディングは、単純に接着剤で貼るといっても、その手順は厳密に管理されています。
大まかな流れとしては、「接着剤の塗布」から「チップの搭載」、そして「硬化」という3つのステージで進行します。
各工程で何が行われているのか、順を追って解説します。
チップの用意
作業を始める前に、まずは搭載する半導体チップの状態を確認します。
前工程である「ダイシング」で切り出されたチップは、バラバラにならないように「キャリアテープ」と呼ばれるテープ上に固定された状態で運ばれてきます。
ダイボンダーはこのテープ上のチップを一つひとつ認識し、ピックアップしていく準備を整えます。
接着剤の塗布
次に、チップを載せる土台(リードフレームや基板のマウント部)に接着剤を用意します。ここでの手法は主に3つのパターンがあります。
- 樹脂接着法(ペースト)
- フィルム接着法
- 共晶合金結合法
1.樹脂接着法(ペースト)
銀(Ag)ペーストなどの液状接着剤を、スタンプやディスペンサーで塗布する方法です。一般的によく用いられます。
2.フィルム接着法
「ダイボンディングフィルム」や「DAF」と呼ばれる薄い膜状の接着剤を使用します。厚みが均一で、積層(スタック)しやすいのが特徴です。
3.共晶合金結合法
金とシリコンなどの合金材料を使い、熱で溶かして接合する方法です。
チップ貼り付け
接着剤の準備ができたら、いよいよチップを移動させます。
「コレット」や「ノズル」と呼ばれる吸着器具を使用して、キャリアテープからチップを吸着し、接着剤が塗布されたマウント部へと運びます。
この際、チップを正しい位置に、適切な圧力(荷重)で押し付けることが重要です。
もし位置がズレたり、圧力が強すぎたりすると、チップが破損する原因になるため、装置には高度な制御技術が求められます。
チップの加熱・固定
最後に、接着剤を硬化させてチップを完全に固定します。
- 銀ペーストの場合: ベーキング炉に入れ、約250℃まで加熱して硬化させます。
- フィルムの場合: 100℃程度で軟化させて貼り付けた後、170〜260℃程度まで加熱して硬化させます。
- 共晶接合の場合:酸化を防ぐ特殊な環境下で、約400℃の高温を加えて接合します。
この加熱処理(キュア)が終わると、チップは強固に固定され、次の工程へと進むことができます。
ダイボンディングとワイヤーボンディングの違い
よく混同されがちな「ダイボンディング」と「ワイヤーボンディング」ですが、この2つは役割もタイミングも明確に異なります。
ダイボンディング(土台への固定)
チップを基板やリードフレームに「物理的に接着・固定」する工程です。電気的な配線を行う前の準備段階と言えます。
ワイヤーボンディング(電気的な配線)
ダイボンディングの後に行われる工程です。
固定されたチップの電極と、基板側の電極を、金(Au)や銅(Cu)の極細ワイヤーで繋ぎ、「電気的に接続」します。
つまり、「ダイボンディングで家(チップ)を土地(基板)に建てて固定し、ワイヤーボンディングで電気(配線)を通す」とイメージするとわかりやすいでしょう。
どちらも半導体が機能するために欠かせない、セットのような関係性です。
まとめ
ダイボンディングは、半導体チップを正確に固定し、放熱性や信頼性を支える重要なプロセスです。
接着方法や加熱条件、位置精度のわずかな違いが、最終製品の性能や寿命に直結します。
ワイヤーボンディングとの役割の違いを理解することで、後工程全体の流れもより立体的に見えてくるでしょう。
【参考文献】
今と未来がわかる半導体(ナツメ社)
長年の経験と独自の技術で、大学や研究機関での導入実績も多数。
研究目的に応じたカスタマイズや、導入前のテスト成膜も可能です。
装置のご検討やその他ご相談は、ぜひ当社までお問い合わせください。