
半導体製造の後工程の中でも、製品の品質や歩留まりを大きく左右するのが「ダイシング工程」です。
1枚のウエハーを個々のチップへ切り分けるこの工程では、切断方式や装置条件の違いが、クラックや欠けの発生、さらには最終的な信頼性にまで影響を与えます。
本記事では、ダイシングの基本的な役割をはじめ、代表的な4つの方式それぞれの原理や工程の流れ、装置選定時に押さえておきたいポイントを整理しました。
ダイシング工程を体系的に理解したい方に向けて、実務にも役立つ視点で解説します。
長年の経験と独自の技術で、大学や研究機関での導入実績も多数。
研究目的に応じたカスタマイズや、導入前のテスト成膜も可能です。
装置のご検討やその他ご相談は、ぜひ当社までお問い合わせください。
お問合せはこちら半導体技術に関心をお持ちの皆様に、基礎から学べる情報をお届けしたいという思いから、本連載を開始いたしました。
「これから半導体について学びたい」「技術の背景を理解したい」とお考えの方に向けて、できる限り平易で役立つ内容を発信してまいります。
当社「菅製作所」は、研究開発用途の真空装置を製造・販売しております。
現場で培ってきた知見をもとに、皆様の学びに少しでも貢献できれば幸いです。
本連載が、半導体に関する疑問の解消や、さらなる理解への一助となることを願っております。
ぜひ最後までご覧ください。
半導体製造【後工程】で用いられるダイシングとは?
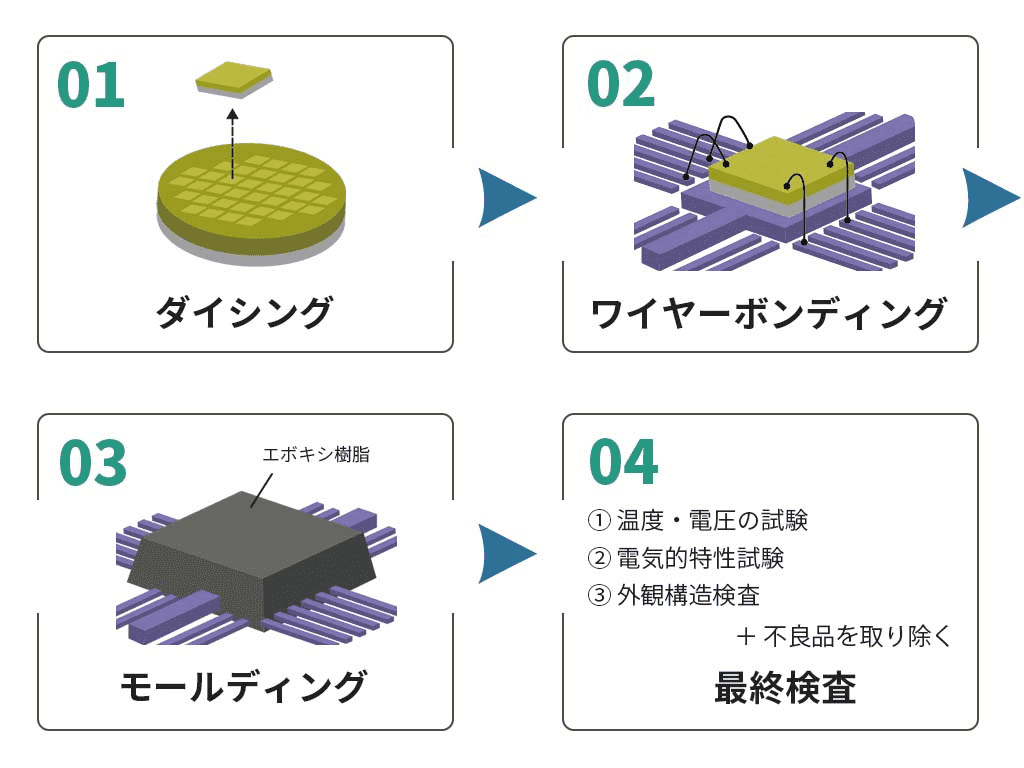
ダイシングとは、半導体ウエハー上に形成された多数の集積回路(IC)を、個々のチップ(ダイ)として切り出す分割工程のことを指します。
ウエハー1枚には同一回路が多数形成されており、それらを製品単位に分離するために欠かせない工程です。
半導体後工程の中でも初期段階に位置づけられており、スマートフォンやPCなどに搭載されるICチップを量産するうえで重要な役割を担います。
この工程の精度が、その後のパッケージング品質や製品信頼性に大きく影響します。
ダイシングの目的
ダイシングの主な目的は、ウエハー上の各チップを高精度かつ効率よく個片化し、次のパッケージング工程へ安定供給できる状態にすることです。
量産工程であるため、精度だけでなくスループットも重視されます。
切断は、チップ間に設けられた「スクライブライン(ダイシングストリート)」に沿って行われます。
この際、チップの欠けやクラック、異物付着を抑え、歩留まりと信頼性を確保することが重要です。
さらに、切りしろを極力小さくすることで、1枚のウエハーから得られる有効チップ数を増やし、製造コストの低減につなげる役割も担っています。
ダイシングの原理|4つの加工方式
ダイシングの原理は、採用する加工方式によって異なりますが、現在主に用いられている代表的な方法は4つあります。
いずれもウエハー上のチップを高精度に分離することを目的とし、デバイス構造や要求精度、生産条件に応じて使い分けられています。
以下では、それぞれの原理と特徴について解説します。
ブレードダイシングの原理
ブレードダイシングは、ダイヤモンド砥粒を含んだ極薄の円盤状ブレードを高速回転させ、ウエハーに直接押し当てて機械的に切断する方式です。
切断時には摩擦熱や切りくずが発生するため、純水などの冷却水を連続供給し、温度上昇の抑制と切りくず除去、ブレードの目詰まり防止を行います。
ウエハーは事前にダイシングテープへ固定され、ブレードはスクライブラインに沿って所定深さまで侵入します。
安定した加工精度と量産性の高さから、現在も広く採用されている方式です。
レーザーダイシングの原理
レーザーダイシング(アブレーション)は、高エネルギーのレーザー光をウエハー表面に照射し、材料を局所的に蒸発・昇華させて溝を形成する非接触加工方式です。
レーザーの走査軌跡を制御することで切断ラインを作り、ウエハーを分割します。
機械的な接触がないため、薄いウエハーや複雑形状の加工に適しています。
一方で、熱影響やデブリ(加工くず)の発生に対する対策が必要となる場合があります。
ステルスダイシングの原理
ステルスダイシングは、レーザーの焦点をウエハー表面ではなく内部に合わせ、内部に改質層(脆化層)を形成した後、外力によって割断する方式です。
レーザーをストリートに沿って走査し、連続した改質層を形成します。
その後、テープエキスパンドなどでウエハーを引き伸ばすことで、改質層を起点としてチップが分離されます。
完全非接触で表面ダメージや加工くずがほとんど発生しないため、微細配線やストレスに弱いデバイスに適しています。
プラズマダイシングの原理
プラズマダイシングは、プラズマエッチング技術を応用し、化学反応によって材料をガス化・除去することでチップを切り出す方式です。
ストリート部以外をマスクで保護し、反応性プラズマを用いてシリコンを垂直方向に掘り進めます。
機械的負荷がほぼなく、ウエハー全面を一括加工できる点が特徴です。
極薄ウエハーや微小チップの大量生産に有効ですが、金属膜や複雑な積層構造では制約が生じる場合があります。
ダイシング工程の流れ
ダイシング工程は、ウエハーを個々のチップに分割し、次のパッケージング工程へつなぐ重要なプロセスです。
ここでは、一般的なダイシング工程の流れを3つのステップに分けて解説します。
ウエハーの固定
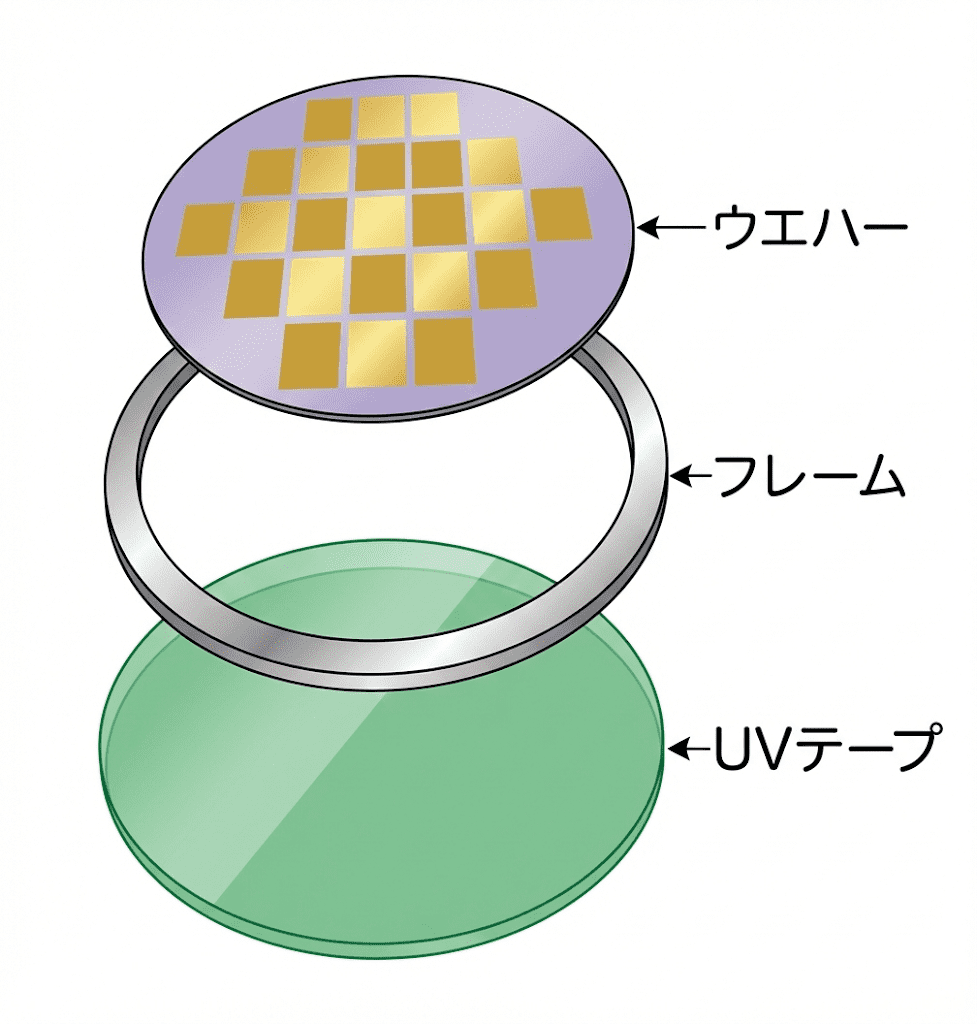
ダイシング前に、ウエハーはダイシングテープが貼られたフレーム上に置かれます。
テープの粘着力によって裏面から固定することで、加工中のズレや破損を防ぎます。
この際、チップ間に設けられたスクライブライン(切断するための目印の線)の位置と、装置側のアライメントマークを正確に合わせます。
これにより、ダイサーが決められた線の上を正確になぞりながら、安定して切断できる状態が整います。
ダイシング(ウエハーをカットする)
固定したウエハーを装置にセットし、選択した方式に応じて切断加工を行います。
ブレード方式やレーザー方式では、スクライブラインに沿って順次切断が進められます。
一方、プラズマダイシングでは、ウエハー全面を一括でエッチングして分割します。
ステルスダイシングの場合、この工程では内部に改質層を形成し、後工程で完全に分割させるケースもあります。
加工中、とくにブレード方式では、純水などの冷却水を切断点に供給します。
摩擦熱の抑制と切りくず除去を同時に行い、加工品質の安定化を図ります。
ピックアップ(良品チップの回収)
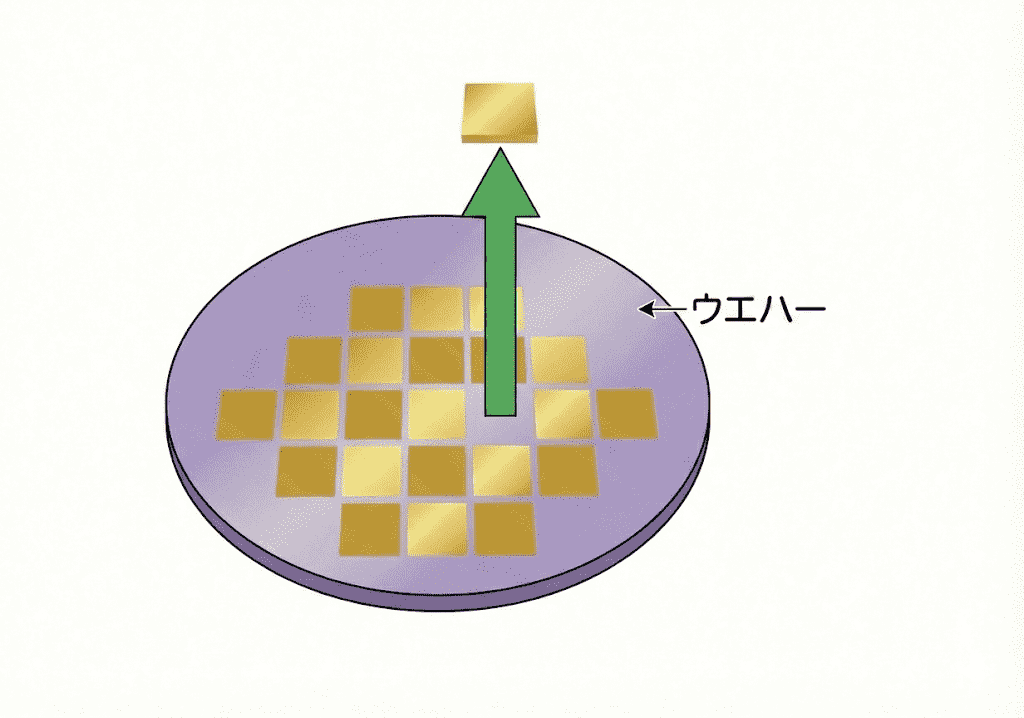
ダイシング後は、テープエキスパンド工程によりテープを引き伸ばし、チップ同士の間隔を広げます。
ステルスダイシングでは、この伸展応力によってチップ分割が完了します。
その後、ダイボンダーやピックアップツールを用いてチップを一つずつ吸着します。
外観検査や電気特性検査で不良品を除外し、良品チップのみが次のパッケージング工程へ供給されます。
ダイシング装置を選ぶ際のポイント
ダイシング装置を選定する際は、「どのようなウエハーを、どの方式で、どの程度の品質とスループットで切断するか」を軸に検討することが重要です。
材料特性やデバイス構造、生産量によって最適な装置条件は大きく異なります。
以下では、装置選定時に押さえておきたい5つのポイントを解説します。
ブレードの種類(厚さ・粒度)と選定
ブレードダイシングでは、ウエハー材料や要求される切断精度に応じて、ダイヤモンドブレードの厚さや粒度を適切に選ぶ必要があります。
SiCなどの硬質材料には耐久性を重視した厚めのブレードが用いられます。
一方、微細加工や切りしろ低減が求められる場合は、粒度が細かく薄いブレードが適しています。
ブレード選定は、切断品質だけでなく歩留まりやコストにも直結する要素です。
冷却システムの仕様と熱影響への対策
切断時に発生する熱を適切に抑えるため、冷却システムはダイシング装置に不可欠な要素です。
特に高速切断や熱に弱い材料を扱う場合、冷却性能の差が品質に大きく影響します。
冷却が不十分だと、クラックや反り、ブレード寿命の低下を招く恐れがあります。
安定した加工を行うためには、十分な冷却能力を備えたシステムの選定が重要です。
アライメントシステムの精度と歩留まり
CMOSセンサーやMEMSなどの微細デバイスでは、アライメント精度が製品信頼性と歩留まりを左右します。
切断ラインがスクライブラインからずれると、チップ欠けや機能不良につながるため注意が必要です。
高精度なアライメントシステムを備えた装置を選ぶことで、切断誤差を最小限に抑え、安定した品質を確保できるでしょう。
切断速度と生産性のバランス
切断速度は生産性に直結する重要な指標ですが、速度を上げすぎると精度低下やクラック発生のリスクが高まります。
大量生産や短納期対応が求められる現場では、処理能力の高さが重要です。
一方で、ウエハーの厚みやチップサイズ、加工方式によって最適な速度条件は異なります。
品質と生産性のバランスを柔軟に調整できる装置かどうかが、選定時の判断基準となるでしょう。
導入コストとランニングコスト
ダイシング装置の選定では、初期導入コストだけでなく、運用時に発生するランニングコストも考慮が必要です。
ブレードやレーザーの消耗品費、保守費用、電力や純水の使用量などは方式によって大きく異なります。
使用頻度や求める精度、生産規模を踏まえ、トータルコストの観点から最適な装置を見極めることが重要です。
まとめ
半導体製造の後工程におけるダイシングは、ウエハーを製品として成立させるために欠かせないプロセスです。
ブレード、レーザー、ステルス、プラズマといった各方式にはそれぞれ特性があり、デバイス構造や材料、生産条件に応じた使い分けが求められます。
また、装置選定においては切断精度や生産性だけでなく、熱影響や歩留まり、コストまで含めた総合的な視点が重要です。
長年の経験と独自の技術で、大学や研究機関での導入実績も多数。
研究目的に応じたカスタマイズや、導入前のテスト成膜も可能です。
装置のご検討やその他ご相談は、ぜひ当社までお問い合わせください。
【参考文献】
今と未来がわかる半導体(ナツメ社)