
ALD(Atomic Layer Deposition:原子層堆積法)とは、原子レベルで膜厚を制御しながら薄膜を形成できる成膜技術です。
自己制限的な表面反応を利用して、原子層を1層ずつ積み上げることで膜を形成します。高アスペクト比構造でも均一な成膜が可能なため、半導体をはじめとする先端分野で広く利用されています。
しかし、「CVDとの違いは?」「どのような用途で使われるのか?」と疑問に思う方も多いのではないでしょうか。
この記事では、ALDの原理や特徴、CVD・スパッタリングとの違い、主な用途をわかりやすく解説します。
記事の後半では、菅製作所が販売するALD装置も紹介します。研究開発向けのALD装置を検討している方は、ぜひ最後までご覧ください。
▼ALD装置については、以下の記事でも詳しく解説しています。
長年の経験と独自の技術で、大学や研究機関での導入実績も多数。
研究目的に応じたカスタマイズや、導入前のテスト成膜も可能です。
装置のご検討やその他ご相談は、ぜひ当社までお問い合わせください。
お問合せはこちら目次
ALD(原子層堆積)とは何か
原子層堆積(ALD:Atomic Layer Deposition)は、ナノスケールで極めて精密な薄膜を形成するための先端的な成膜技術です。
半導体デバイスの高性能化に伴い、より微細な構造が求められる中で、ALDは原子1層ずつ膜を成長させることで、高密度かつ均一な膜を実現し、最先端技術を支える重要な装置として注目されています。
①ALDの原理とプロセス
ALDの基本原理は、自己制限的な表面反応を利用して原子層単位で膜を形成する点にあります。
反応は基板表面の反応サイトが埋まると自然に停止するため、膜厚を原子レベルで制御でき、優れた膜厚均一性と段差被覆性(ステップカバレッジ)を実現します。
ALDでは、前駆体ガスを交互に導入するサイクルを繰り返すことで薄膜を堆積させます。
例えば、Al(CH3)3(TMA)とO2プラズマまたは水(H2O)を用いてAl2O3(酸化アルミニウム)を成膜する場合、前駆体導入とパージ、反応ガス導入とパージという4つの工程を1サイクルとして進行します。
- 第1前駆体導入:
基板にTMAなどの前駆体ガスを導入します。ガスは基板表面に吸着して反応を起こしますが、反応サイトが埋まるとそれ以上は反応が進まず、余分なガスは排気されます。
- パージ:
反応しなかった前駆体や副生成物(例:メタンCH4)をN2やArなどの不活性ガスで排出し、チャンバー内を清浄な状態に保ちます。
- 第2前駆体導入(反応ガス導入):
第2前駆体として酸素ラジカルや水などの反応ガスを導入し、表面に吸着した前駆体と反応させます。この反応によって、基板表面に1層の薄膜が形成されます。
- パージ:
最後に再度パージを行い、残留ガスや副生成物を除去します。
この一連のサイクルでオングストロームレベルの膜が形成され、必要な膜厚になるまで繰り返すことで成膜が進みます。
ALDはこのように「Layer by layer」で膜を形成するため、パルス成膜法やデジタル成膜法とも呼ばれます。
▼薄膜干渉の仕組みについては動画で詳しく解説していますので、あわせてご覧ください。
②ALDの主な特徴と利点
ALDは、自己制限的な表面反応を利用する独自の成膜方式により、他の成膜技術では実現しにくい特長を持っています。
特に、膜厚制御の精度や複雑な構造への成膜性能に優れている点が大きな強みです。
| 超薄膜の精密制御 | 原子レベルで数nmの膜厚を正確に制御 |
| 優れた段差被覆性 | 複雑な形状や細孔内壁にも均一に成膜(コンフォーマル性) |
| 高品質な成膜 | 表面反応により、ピンホールや異物(パーティクル)が極少 |
| 低ダメージ・低温 | 基板に優しく、低温プロセスが可能 |
| 高い密着性 | 共有結合により、基板から剥がれにくい |
| 高い再現性 | 膜厚の厳密なコントロールにより安定した品質を維持 |
| 幅広い材料への対応 | 様々な材料での薄膜形成が可能 |
③ALDの種類
ALDには、反応を促進する方法の違いによっていくつかの方式があります。代表的なのが「サーマルALD」と「プラズマALD(PE-ALD)」です。
- サーマルALD(熱ALD)
熱エネルギーによって前駆体の表面反応を進める方式です。
プラズマを使用しないためプロセスが比較的シンプルで、安定した成膜が可能です。自己制限反応による高い段差被覆性を活かし、複雑な三次元構造へのコンフォーマルコーティングに適しています。
- プラズマALD(PE-ALD)
反応ガスをプラズマで活性化して表面反応を促進する方式です。低温でも反応性を高められるため、熱に弱い材料への成膜が可能になります。
膜密度の向上や不純物の低減、低抵抗化など、膜質の改善が期待できます。
リモートプラズマ源を用いることで、基板へのプラズマダメージを抑えながら成膜を行うことも可能です。
菅製作所でもお客様からの多くのご要望を受けてプラズマALDの開発を行っております。今後の発表をぜひ楽しみにしていて下さい。
④対応可能な材料
菅製作所のALD装置で社内実績があるのは下記の4種です。
酸化物:Al2O3、HfO2、SiO2、TiO2
▼ALD(原子層堆積法)の「プリカーサ」については、以下の記事・動画で詳しく解説しています。
半導体製造におけるALDの役割
半導体デバイスの高性能化と微細化を支える技術として、ALDは重要な役割を担っています。
原子層を1層ずつ積み重ねることで、膜厚を原子レベルで細かく制御できるためです。
加えて、複雑な構造にも均一な薄膜を形成しやすく、信頼性の向上にもつながります。
ここでは、半導体製造においてALDが欠かせない理由を3つの観点から解説します。
高精度な薄膜形成と微細化への対応
半導体の微細化が進むほど、薄膜にはナノメートル単位の精密な制御が求められます。
ALDは化学反応を利用し、ウエハー表面に原子を1層ずつ積み重ねるため、極めて薄い膜でも高い精度で形成できます。
例えば、トランジスタのゲート絶縁膜のように、膜厚のわずかな違いが性能に影響する部分でも安定した成膜が可能です。
そのため、微細化が進む半導体製造に適した技術といえます。
複雑な構造への均一な成膜
現代の半導体デバイスでは、3D NANDメモリのような複雑で高アスペクト比の構造が使われています。
このような形状では、側面や底面まで均一に膜をつけることが難しいという課題がありました。
ALDはプリカーサーガスが表面全体に行き渡るため、凹凸のある複雑な構造にも均一な成膜ができます。
結果として、膜のばらつきを抑えやすくなり、デバイスの安定性と信頼性の向上に役立ちます。
バリア層としての重要な機能
配線が密集する半導体デバイスでは、隣り合う配線間の電流リークや不要な化学反応を防ぐことが欠かせません。
ALDで形成される薄膜は、緻密で欠陥が少ないため、バリア層として優れた性能を発揮します。
膜が均一で質も安定しやすいため、配線まわりの保護に適しています。
こうした特性により、デバイスの性能維持だけでなく、長期的な信頼性を支える重要な機能も果たしているのです。
▼半導体製造に不可欠なALD装置については、動画でも詳しく解説しています。理解を深めたい方はぜひご覧ください。
ALDが実現する究極の均一性:面内分布とは?
ALDの面内分布とは、ウエハー表面全体に形成された薄膜がどれだけ均一な膜厚や組成を保っているかを示す重要な指標です。
半導体製造では、膜のわずかなばらつきでもデバイス性能や信頼性に影響するため、高い均一性が求められます。
ALDは原子層単位で成膜を行うため、膜厚を精密に制御しやすく、安定した品質を維持できます。
ここではALDがどのように高い均一性を実現するのか、その仕組みと特徴を解説します。
自己制限反応による原子レベルの膜厚制御
ALDは、ガス状の原料が基板表面で自己制限的に反応する仕組みを利用して成膜します。
この反応は一定量の原料が表面に吸着すると自然に停止するため、過剰に膜が成長することがありません。
その結果、原子1層ずつ積み重ねる「Layer by layer」の成膜が可能になります。
膜厚をサイクル数で細かく調整できるため、ウエハー全体で均一な薄膜を形成しやすく、精密なプロセス制御を実現します。
高い被覆性による複雑構造への均一成膜
半導体デバイスの微細化が進むにつれて、3D構造や高アスペクト比構造が多く採用されるようになりました。
このような形状では、側壁や底部まで均一に膜を形成することが難しくなります。
ALDは原料ガスが表面全体に拡散しながら反応するため、複雑な凹凸構造にも沿って均一な成膜が可能です。
従来のスパッタリングなどの技術では難しかった領域にも対応できる点が、ALDの大きな強みといえるでしょう。
▼ALD(原子層堆積法)の「面内分布」については、以下の記事・動画で詳しく解説しています。
ALD Windowについて
ALDの自己制御性が成立するプロセスパラメーターの最適範囲を「ALD Window(窓)」と呼びます。
この範囲を外れると、自己制御性が失われたり、膜成長が阻害されたりします。
ALD Windowは、前駆体、反応ガス、プラズマ源、基板温度、真空装置の排気性能など、様々な条件によって変化するのです。
ALD、CVD、スパッタリングの違い
成膜には、スパッタリングやCVD(化学的気相法)など多彩な装置・手法があります。
同じ物質を成膜にする上でも、手法によって特性が変わる場合もあります。以下に、よく比較される3つの方法を整理しました。
| 化学気相成長(CVD)法 | 成膜したい元素を含む気体を基板表面に送り、化学反応、分解を通して成膜する方法。CVDの中にも基板を加熱させる熱CVD、反応管内を減圧し、プラズマを発生させるプラズマCVDなどの種類がある。 |
|---|---|
| スパッタリング法 | 放電によるプラズマ中にできたイオン(通常Ar+イオン)を成膜材料の板(ターゲット)にぶつけて材料をはね飛ばします。はね飛ばされた成膜材料が基板へ飛んでいき薄膜を形成する手法です。スパッタリング法では、高融点金属や合金など、蒸着法では困難な材料でも、成膜が可能で、広範囲な成膜材料に対応できます。 |
| 原子層堆積(ALD)法 | CVDの1種と言われますが、2種類以上の原料気体(プリカーサー,前駆体)を交互に導入・排気を繰り返し,成膜表面に吸着した原料分子を反応させて膜化する方法を原子層堆積(ALD)といいます。 |
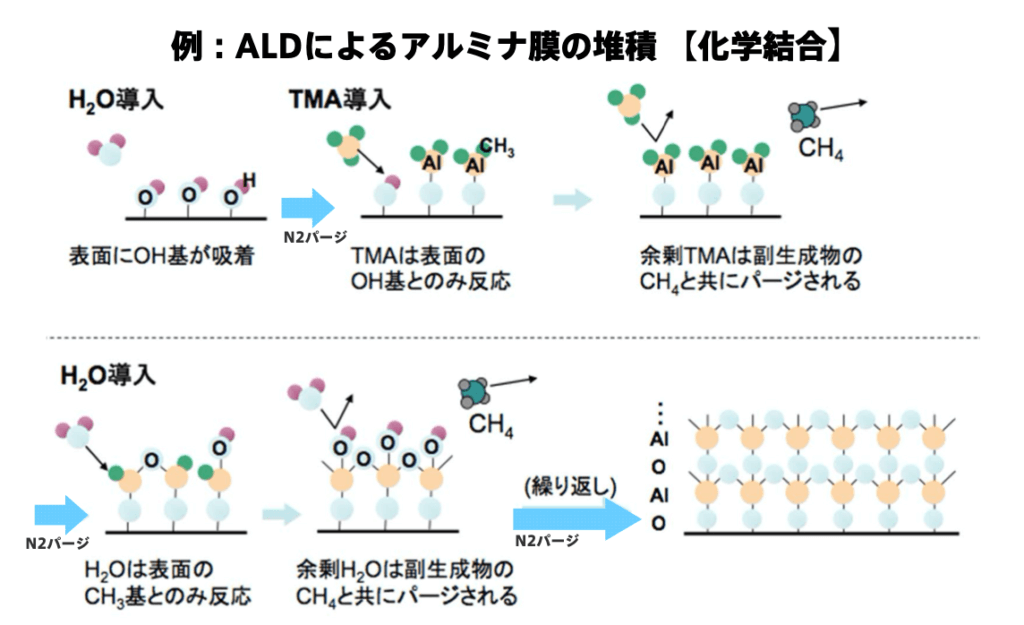
ALDは、原子1層ごとの精密な堆積制御により、CVDやスパッタリングでは難しい高精度かつ均一な薄膜形成が可能です。
特に、複雑な3D構造や高アスペクト比の微細構造へのコンフォーマルコーティングにおいて優位性があります。
▼ALD(原子層堆積法)についてもっと深く理解したい方は、下記の記事・動画もぜひご覧ください。
ALDの応用
ALD技術は、さまざまな先端分野での活用が期待されています。代表的な応用分野としては、半導体デバイス、ディスプレイ、太陽電池、MEMS/NEMSなどが挙げられます。
さらに近年では、2D材料や量子コンピューターデバイス、GaNパワー半導体、ペロブスカイト太陽電池など、次世代技術への応用にも注目が集まっています。
こうした幅広い分野で高品質な薄膜形成が求められていることから、ALD技術の重要性は今後さらに高まっていくと考えられています。
▼ALDの応用については、以下の記事・動画で詳しく解説しています。さらに理解を深めたい方はぜひご覧ください。
菅製作所のALD装置一覧
大学の研究所でも導入実績のあるALD装置をご紹介します。
弊社では部品が壊れたらすぐに対応するのはもちろんのこと、研究開発の目的に応じて装置をカスタマイズすることも可能です。お気軽にご相談ください。
導入実績はこちら 菅製作所|ALD装置一覧▼菅製作所では、有償でテスト成膜を承っております。どのような膜が成膜できるかお試しいただけますので、ぜひご活用ください。
テスト成膜サービスはこちら お問い合わせはこちらSAL1000|デスクトップ型(小型)ALD装置

ALD装置のエントリーモデルです。手軽に1原子層ずつの薄膜をつくれます。
【POINT】
- 使いやすさを重視した小型のALD
- 1種類の膜種を成膜する最低限の構成仕様
- デモ機によるテスト成膜が可能
【本体寸法】
W450mm×D450mm×H410mm
| プリカーサ | 2個 |
|---|---|
| 膜厚分布 | ≦±3% |
| 基板加熱 | 350℃ |
| 複合化 | × |
SAL1000は研究開発用のALD装置(原子層堆積装置)です。
SAL1000はプリカーサを2系統搭載し、1種類の膜種の成膜に必要な基本機能を備えたエントリーモデルのデスクトップ型ALDです。
※例に挙げている膜種に関しては、弊社では実証できていないものが含まれております。
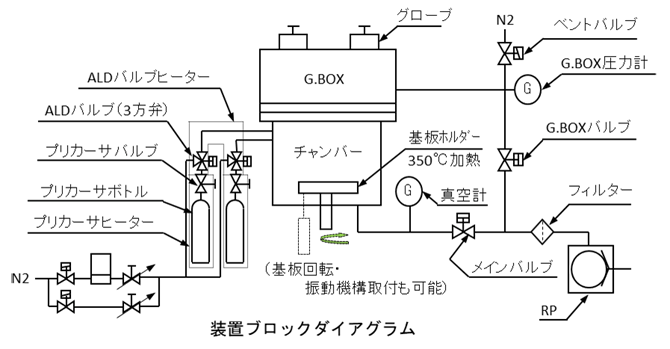
▶PDFカタログ・お問い合わせはこちらから
SAL1000B|粉体成膜用ALD装置

粉体への全周囲成膜を可能にしたALD。卓上型の研究開発用成膜装置です。
【POINT】
- 傾斜+回転+振動で粉体へ成膜可能
- 傾斜角度は水平から45°まで調節可能
- 実は4インチの基板も成膜もできる
【本体寸法】
W582mm×D450mm×H410mm
| プリカーサ | 2個 |
|---|---|
| 膜厚分布 | ≦±3% |
| 基板加熱 | 350℃ |
| 複合化 | × |
研究開発用の粉体成膜に特化したALD装置(原子層堆積装置)です。
SAL1000Bはプリカーサを2系統搭載した、粉体成膜用途のデスクトップ型ALDです。
粉体への全周囲成膜を可能としたことにより、粉体や粒状の材料に関わる分野で新素材の開発などに活躍します。
※例に挙げている膜種に関しては、弊社では実証できていないものが含まれております。
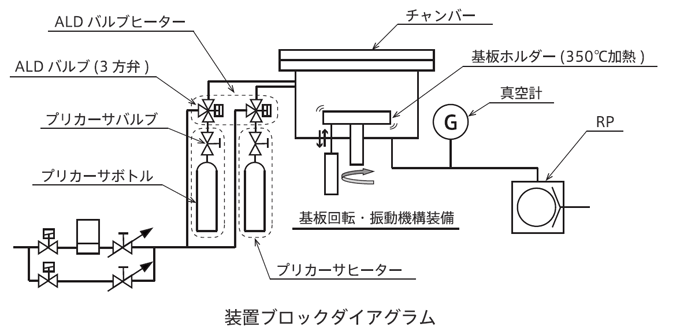
▶PDFカタログ・お問い合わせはこちらから
SAL1000G|グローブボックス付きALD装置
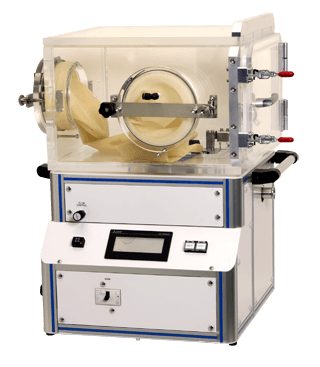
ウエハーまたは粉体への成膜が可能。機能と性能を兼ね備えた卓上型ALDです。
【POINT】
- 真空置換対応のグローブボックス搭載
- 嫌気性のサンプルや材料に対応
- オプションで粉体への成膜が可能
【本体寸法】
W690mm×D590mm×H760mm
| プリカーサ | 2個 |
|---|---|
| 膜厚分布 | ≦±3% |
| 基板加熱 | 350℃ |
| 複合化 | × |
研究開発用の卓上型ALD装置(原子層堆積装置)です。
SAL1000Gは、卓上型ALDにグローブボックスを装備し、酸化や大気と反応する嫌気性の材料を用いた成膜ニーズに対応するモデルです。
また、オプションの粉体成膜用振動機構及び傾斜フレームを装備することで、粉体への全周囲成膜も可能としました。
※例に挙げている膜種に関しては、弊社では実証できていないものが含まれております。
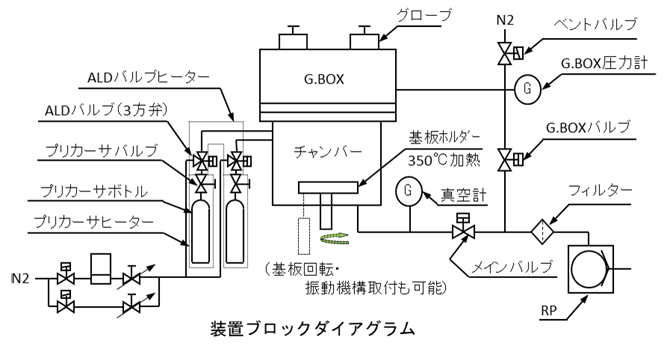
▶PDFカタログ・お問い合わせはこちらから
SAL1100|ドラム型ALD装置

従来モデルSAL1000Bの最大5ccから32倍に容量UP!1バッチ160ccのペレットや粉体に成膜可能。ドラム型の研究開発用ALD成膜装置です。
【POINT】
- 斜め回転ドラム式アルミ製試料ホルダーを装備、ペレットや粉体を攪拌しながら成膜
- 試料ホルダーは最大50rpmまで回転数を可変可能
- 成膜レシピの記憶/読み込みが可能
【本体寸法】
W1000mm×D1000mm×H1500mm(メンテナンスエリア含む)
| プリカーサ | 2個 |
|---|---|
| 膜厚分布 | 規定なし |
| 基板加熱 | Max400℃ |
| 複合化 | × |
研究開発用の粉体成膜に特化したALD装置(原子層堆積装置)です。
SAL1100はプリカーサを2系統搭載した、粉体成膜用途のドラム型ALDです。
粉体への全周囲成膜を可能としたことにより、粉体や粒状の材料に関わる分野で新素材の開発などに活躍します。
※例に挙げている膜種に関しては、弊社では実証できていないものが含まれております。

▶PDFカタログ・お問い合わせはこちらから
SAL3000|小型ALD装置

小型で機能充実のALDです。
【POINT】
- SAL3000標準型から横幅が4割小型化
- 成膜方向はデポアップかダウンを選択
- デモ機によるテスト成膜が可能
【本体寸法】
W835mm×D700mm×H1644mm
| プリカーサ | 4個(最大6個) |
|---|---|
| 膜厚分布 | ≦±3% |
| 基板加熱 | 350℃(800℃) |
| 複合化 | × |
研究開発用のALD装置(原子層堆積装置)です。
SAL3000は従来からあるデポダウン方式の仕様に加え、基板へのパーティクル付着をより低減できる「デポアップ」タイプをご用意しております。更に目的に合わせ自動基板搬送用ロードロック室や真空置換グローブボックスを選択できるようになっています。
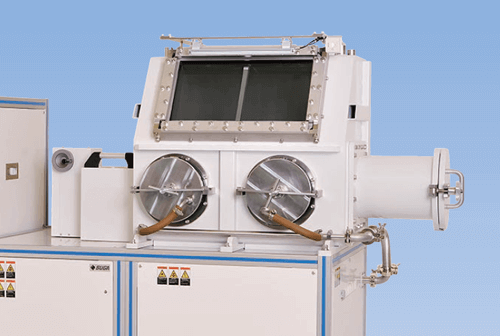
※例に挙げている膜種に関しては、弊社では実証できていないものが含まれております。
▶PDFカタログ・お問い合わせはこちらから
SAL3000Plus|拡張可能型ALD装置

小型で機能充実のALD。他装置との複合化で幅広い実験に対応可能です。
【POINT】
- SAL3000標準型から横幅が4割小型化
- 成膜方向がデポアップとダウンから選択
- Plusシリーズの別装置と連結可能
【本体寸法】
W835mm×D700mm×H1644mm
| プリカーサ | 4個(最大6個) |
|---|---|
| 膜厚分布 | ≦±3% |
| 基板加熱 | 350℃(800℃) |
| 複合化 | 〇(SAL3000+U) |
研究開発用のALD装置(原子層堆積装置)です。
SAL3000PlusはSAL3000の成膜性能を維持したまま本体の大幅な小型化に成功し、加えて他の装置との複合化も実現による幅広い成膜プロセスに対応した高性能ALD装置です。
SAL3000Plusは、本体側面に拡張用ポートを備えており、トランスファーユニットSTR2000と連結することで、ロードロック機能が備わります。
Plusシリーズのスパッタ装置、アニール装置、蒸着装置、そして同じALDのSAL3000Plusと複合化が可能で、基板を大気に曝さず多様な成膜プロセスが可能です(※複合化で組み合わせる装置によっては、接続用のポート位置を左右反転させた構造にする必要があります)。

上記はアニール装置との複合化例です。
※例に挙げている膜種に関しては、弊社では実証できていないものが含まれております。
▶PDFカタログ・お問い合わせはこちらから
SAN1000|卓上アニール・窒化処理装置

基板への高温加熱処理(アニール)や不活性ガス導入による熱処理時の圧力コントロールが可能です。
【POINT】
- N2またはArガス導入時でも1000℃まで均一・急速加熱
- 基板を吹き飛ばさず急速冷却
- 省スペース配置が可能な小型サイズ
【本体寸法】
W582mm×D450mm×H411mm
| プリカーサ | 200℃〜1000℃ |
|---|---|
| 到達圧力 | ≦10Pa |
| 複合化 | 〇(SAL3000+U) |
SAN1000卓上アニール・窒化処理装置は、4インチまでの基板を赤外線照射により、真空中またはガス雰囲気中のクリーンな環境で加熱処理することができます。
また、卓上設置型ができる小型サイズで、チャンバーに水冷機構、基板にガスフローによる冷却機構を備えており処理後の基板を短時間で取り出すことのできるバッチ式の装置です。

▶PDFカタログ・お問い合わせはこちらから
SAN2000Plus|アニール装置

基板への高温加熱処理(アニール)や反応性ガス導入による熱処理が可能です。
【POINT】
- 200℃~1000℃の加熱制御機能を搭載
- RF電源搭載モデルならプラズマ処理が可能
- スパッタやALD装置との複合化に対応
【本体寸法】
W608mm×D460mm×H1827mm
| 加熱制御温度 | 200℃〜1000℃ |
|---|---|
| 到達圧力 | 10^-5 |
| プラズマ処理 | 搭載可 |
| 複合化 | 〇 |
SAN2000Plus アニール装置は、4インチまでの基板を強力な赤外照射により、真空中または真空ガス雰囲気中のクリーンな環境で加熱処理することができます。
更に、基板表面の有機膜,金属膜の除去、表面改質等が可能なプラズマプロセス技術をシリーズに加え、基板成膜の前工程処理と後工程処理を1台2役として兼用することが可能です。
装置購入後でもフロッグレッグ基板搬送機構を持つ廉価型STR2000トランスファーと接続可能なため、スパッタ装置,蒸着装置等の成膜装置と容易に複合化することができ、将来拡張するご予定のあるお客様に最適なアニール装置です。
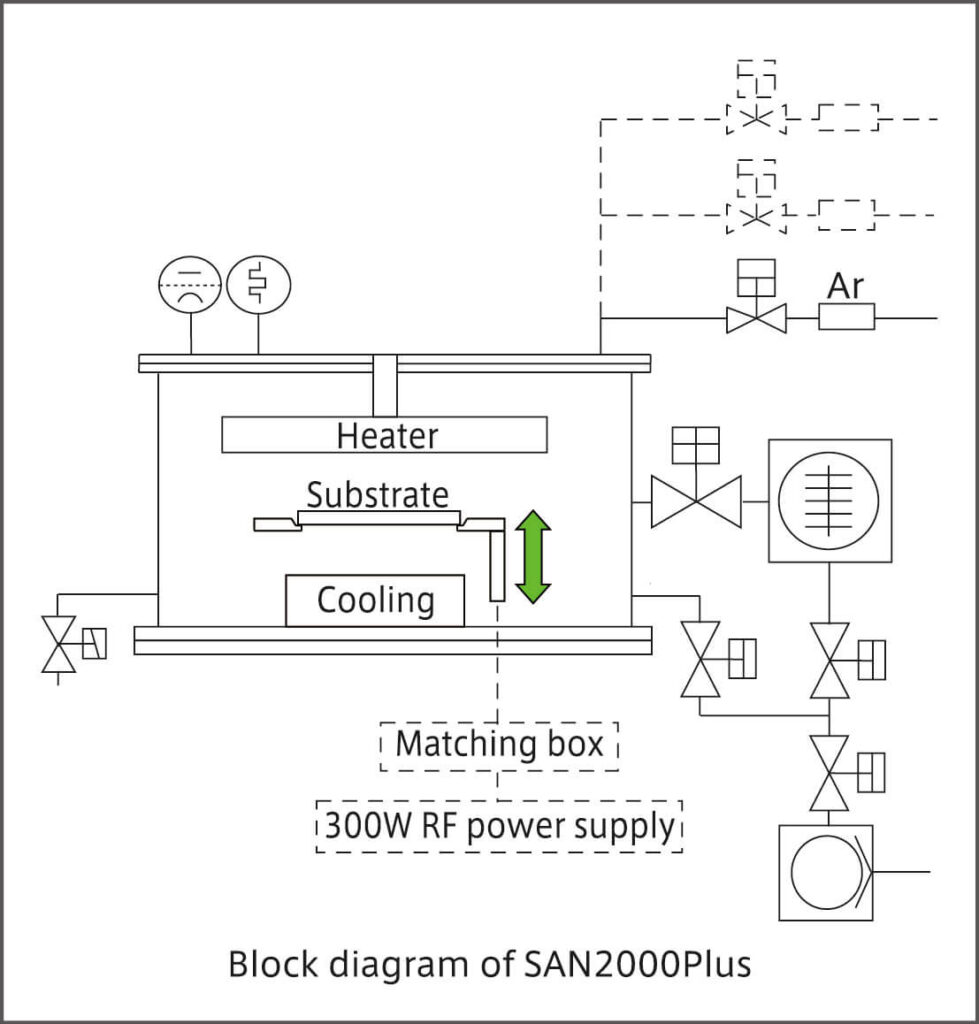
▶PDFカタログ・お問い合わせはこちらから
▶関連動画
まとめ
原子層堆積(ALD)は、自己制限的な表面反応を利用し、原子1層ずつ精密に薄膜を形成する画期的な技術です。超薄膜の正確な制御、優れた均質性・段差被覆性、低ダメージプロセスなど、従来のCVDやスパッタリングにはない多くの利点があります。
半導体、ディスプレイ、太陽電池といった多様な分野でその応用が期待されており、今後も技術革新を牽引するでしょう。適切なALD装置を選定し、その特性を最大限に引き出すことが、高品質な薄膜作製と技術発展の鍵となります。
【参考】
ALDの解説
OXFORD PLASMA TECHNOLOGY『原子層堆積(ALD)』
菅製作所『成膜の種類と特徴を紹介!ALD・CVD・スパッタリングの違いを解説』
長年の経験と独自の技術で、大学や研究機関での導入実績も多数。
研究目的に応じたカスタマイズや、導入前のテスト成膜も可能です。
装置のご検討やその他ご相談は、ぜひ当社までお問い合わせください。













